- お問い合わせ先電話番号
-
産機二部
【東京本社】TEL. 03-5472-1722 - この製品のお問い合わせはこちら
製品
成膜/表面処理
FORGENANO社 ウェハ用ALD(原子層堆積)装置 TEPHRAシリーズ 高精度・高効率な枚葉式成膜装置

製造:Forge nano Inc. / 米国
ForgeNano社の「TEPHRAシリーズ」は、200mm以下のウェハに対応した枚葉式ALD(原子層堆積)装置です。CRISP™プロセスにより、プラズマ不要で低温・高均一な成膜を実現し、最大25:1の高アスペクト比構造にも対応。独自の高速ドージングバブルと前駆体利用効率90%により、バッチ装置並みのスループットと低コスト運転を両立します。TSV、TGVプロセス、MEMS、マイクロLED、先端パッケージングなど幅広い用途に最適です。
製品の動画
製品の特長
-
ForgeNano社のウェハ用ALD装置は、独自技術により高精度・高効率な成膜を実現します。 [CRISP™プロセスによる低温・高均一成膜] プラズマを使用せず、基板へのダメージを抑えながら80℃からの成膜が可能です。さらに、最大25:1の高アスペクト比構造に対しても均一な膜厚を確保します。 独自設計の高速ドージングバブルによる[迅速・安定した前駆体供給] ミリ秒単位の精密制御で成膜プロセスのスピードと均一性を向上。枚葉式でありながら、バッチ装置並みの生産性を実現します。 [前駆体利用効率の最大化(最大90%)] 高速バルブと不活性ガスカーテンを組み合わせることで、前駆体の利用効率を飛躍的に高め、運転コストを大幅に削減します。
-

ALDx SiO₂ CRISP|バリア用途における高いコンフォーマル成膜
1. 高アスペクト比構造への優れた成膜性能
SiO₂ CRISPは、アスペクト比35:1以上の構造でも完全なギャップフィルを実現。
ブレークダウン耐性を含む優れた電気特性を保持。
2. 湿気・化学バリアとしての有効性
SiO₂ CRISPは、Al₂O₃とのナノラミネート構造に組み込むことで、
環境バリアとして高い性能を発揮。
複数の顧客でナノラミネートを用いた実績あり。
HAST試験(125℃、85%RHで100時間)により、耐湿性が確認済み。
ウェハの反り試験でも、湿気浸透が最小限であることを確認。
-

ケーススタディ|過酷環境でのバリアコーティング性能
試験内容:HAST性能評価
ALDxソリューション:Al₂O₃とSiO₂のナノラミネート構造(ALD-CAP®)
酸素透過率:<1×10⁷ cm³·mm/m²·day
水蒸気透過率(WVTR):<4×10¹⁰ g·mm/m²·day(38℃)
試験条件:
HAST(Highly Accelerated Stress Test)
96時間試験は85℃/85%RHで1000時間相当の加速試験
結果:
PECVD SiN(800nm):96時間・384時間ともに失敗
ALD-CAP®(10nm):96時間は合格、384時間で失敗
ALD-CAP®(20nm):96時間・384時間ともに合格
ポイント:
ALD-CAPはPECVD SiNより優れた耐湿性能を示し、
10nmという極薄膜でも高いバリア性能を発揮。
独自開発のALD技術で、従来比100分の1の薄膜を短時間で実現。 -

ケーススタディ|金属バリアシードコーティング(開発中)
課題 TSVやTGVのCuバリアシード(CBS)プロセスでは、高アスペクト比構造の側壁と底面に連続的な被覆を、最小膜厚で実現することが大きな課題。
従来の方向性成膜法(PVDなど)では、以下の問題が発生:
コーティング不良
通信不良(電気的接続不良)
熱損失増加
デバイス全体の故障
ALDxによる解決策 ForgeNanoのALDx技術は、以下のメリットを提供:
完全なコーティング
高速で信頼性の高い電気接続
より高性能なチップ
エネルギー効率の向上
ポイント
ALDxは、従来の方向性成膜法の限界を克服し、歩留まり改善と次世代技術の実現を可能にする。 -
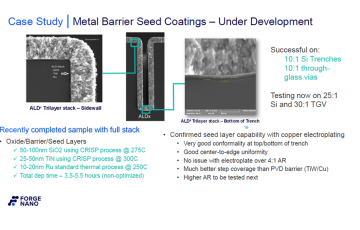
ケーススタディ|金属バリアシードコーティング(開発中)
最近完了したフルスタック試料
酸化膜/バリア層/シード層構成
SiO₂:50~100nm(CRISPプロセス、275℃)
TiN:25~50nm(CRISPプロセス、300℃)
Ru:10~20nm(標準熱ALD、250℃)
総成膜時間:3.5~5.5時間(非最適化状態)
試験結果と性能
銅電解めっきでシード層機能を確認
トレンチの上部・底部で非常に良好なコンフォーマル成膜を実現
ウェハ中心から端まで均一性良好
アスペクト比4:1でも電解めっきに問題なし
PVDバリア(TiW/Cu)より優れたステップカバレッジ
次は25:1 Siトレンチ、30:1 TGVで試験予定
成功実績
10:1 Siトレンチ
10:1 ガラス貫通ビア(TGV) -
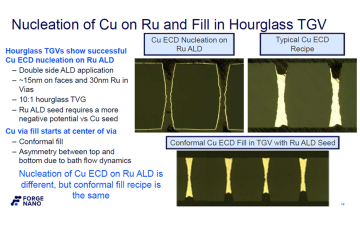
ケーススタディ|Ru上でのCu核生成とHourglass TGVへの充填
試験概要
Hourglass形状のTGVで、Ru ALDシード層上にCu電解めっき(ECD)の核生成が成功。
両面ALD適用により、ビア内部に約30nmのRu、側面に約15nmのRuを形成。
Ruシード層はCuシードよりも負の電位が必要。
Cu充填の特徴
ビア中央から充填が開始し、コンフォーマル(均一)な充填を実現。
上下方向でわずかな非均一性が確認されており、これは薬液槽の流体挙動に起因すると考えられる。
重要ポイント
Cu ECDの核生成はRu ALD上では異なるが、充填レシピは従来と同じ。
高アスペクト比構造でも均一なCu充填が可能。 -
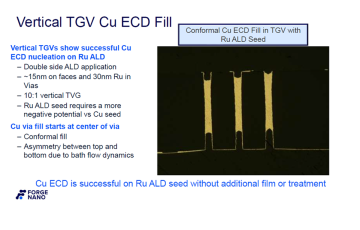
ケーススタディ|垂直TGVでのCu電解めっき充填
試験概要
垂直TGV構造で、Ru ALDシード層上にCu電解めっき(ECD)の核生成と充填が成功。
両面ALD適用により、ビア内部に約30nmのRu側面に約15nmのRuを形成。
Ruシード層はCuシードよりも負の電位が必要。
Cu充填の特徴
ビア中央から充填が開始し、コンフォーマル(均一)な充填を実現。
上部と下部で若干の非対称性が見られるが、
これは薬液槽の流体挙動に起因すると考えられる。
重要ポイント
Cu ECDはRu ALDシード上で追加の膜や処理なしで成功。
高アスペクト比構造でも均一なCu充填が可能。 -
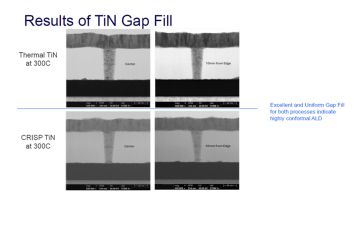
TiNギャップフィルの結果
試験条件
Thermal TiN(熱ALD):300℃
CRISP TiN(CRISPプロセス):300℃
結果
両プロセスとも、ギャップフィル性能は非常に優秀で均一。
ウェハ中央および端部(10mm位置)で均一な成膜が確認され、
高いコンフォーマリティ(密着性)を示す。
ポイント
CRISPプロセスは、従来の熱ALDと同等以上の均一性を確保しつつ、
低ダメージで高アスペクト比構造に対応可能。
高精度なギャップフィルは、
先端半導体やパッケージング用途で重要な特性。
製品の適用例
製品の仕様